因為專業
所以領先


芯片封裝技術大全(上)
今天小編給大家分享一篇關于芯片封裝技術的相關知識,希望能對您有所幫助!
1、BGA/ball grid array
BGA/ball grid array也稱CPAC(globe top pad array carrier)。球形觸點陳列,表面貼裝型封裝之一。在印刷基板的背面按陳列方式制作出球形凸點用以代替引腳,在印刷基板的正面裝配LSI 芯片,然后用模壓樹脂或灌封方法進行密封。也稱為凸點陳列載體(PAC)。引腳可超過200,是多引腳LSI用的一種封裝。封裝本體也可做得比QFP(四側引腳扁平封裝)小。例如,引腳中心距為1.5mm的360引腳BGA僅為31mm見方;而引腳中心距為0.5mm的304 引腳QFP 為40mm 見方。而且BGA不用擔心QFP 那樣的引腳變形問題。
該封裝是美國Motorola 公司開發的,首先在便攜式電話等設備中被采用,隨后在個人計算機中普及。最初,BGA 的引腳(凸點)中心距為1.5mm,引腳數為225。現在也有一些LSI 廠家正在開發500 引腳的BGA。BGA 的問題是回流焊后的外觀檢查。美國Motorola公司把用模壓樹脂密封的封裝稱為MPAC,而把灌封方法密封的封裝稱為GPAC。

2、C-(ceramic)
C-(ceramic)表示陶瓷封裝的記號。例如,CDIP 表示的是陶瓷DIP。是在實際中經常使用的記號。
3、COB (chip on board)

COB (chip on board)
COB (chip on board)是指板上芯片封裝,是裸芯片貼裝技術之一,半導體芯片交接貼裝在印刷線路板上,芯片與基板的電氣連接用引線縫合方法實現,并用樹脂覆蓋以確保可靠性。雖然COB 是最簡單的裸芯片貼裝技術,但它的封裝密度遠不如TAB和倒片焊技術。
4、DIP(dual in-line package)
DIP(dual in-line package) 是指雙列直插式封裝。插裝型封裝之一,引腳從封裝兩側引出,封裝材料有塑料和陶瓷兩種。歐洲半導體廠家多用DIL。DIP 是最普及的插裝型封裝,應用范圍包括標準邏輯IC,存貯器LSI,微機電路等。引腳中心距2.54mm,引腳數從6 到64。封裝寬度通常為15.2mm。有的把寬度為7.52mm和10.16mm 的封裝分別稱為SK-DIP(skinny dual in-line package) 和SL-DIP(slim dual in-line package)窄體型DIP。但多數情況下并不加區分,只簡單地統稱為DIP。另外,用低熔點玻璃密封的陶瓷DIP也稱為Cerdip(4.2)。

4.1 DIC(dual in-line ceramic package)
DIC(dual in-line ceramic package) 是指陶瓷封裝的DIP(含玻璃密封)的別稱。
4.2 Cerdip:
Cerdip是指用玻璃密封的陶瓷雙列直插式封裝,用于ECL RAM,DSP(數字信號處理器)等電路。帶有玻璃窗口的Cerdip 用于紫外線擦除型EPROM 以及內部帶有EPROM 的微機電路等。引腳中心距2.54mm,引腳數從8 到42。在日本,此封裝表示為DIP-G(G即玻璃密封的意思)。
4.3 SDIP (shrink dual in-line package)
SDIP (shrink dual in-line package)是指收縮型DIP。插裝型封裝之一,形狀與DIP 相同,但引腳中心距(1.778mm)小于DIP(2.54mm),因而得此稱呼。引腳數從14 到90。有陶瓷和塑料兩種。又稱SH-DIP(shrink dual in-line package)

5、flip-chip
flip-chip是指倒焊芯片。裸芯片封裝技術之一,在LSI 芯片的電極區制作好金屬凸點,然后把金屬凸點與印刷基板上的電極區進行壓焊連接。封裝的占有面積基本上與芯片尺寸相同。是所有封裝技術中體積最小、最薄的一種。但如果基板的熱膨脹系數與LSI 芯片不同,就會在接合處產生反應,從而影響連接的可靠性。因此必須用樹脂來加固LSI 芯片,并使用熱膨脹系數基本相同的基板材料。
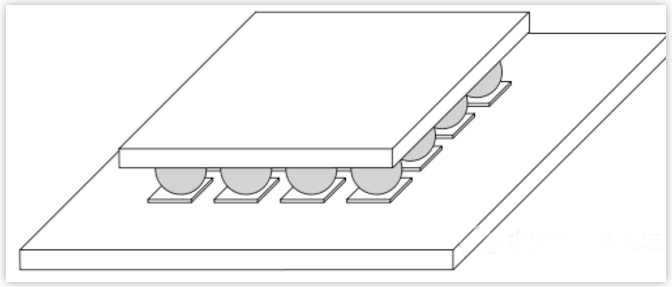
6、FP(flat package)
FP(flat package) 是指扁平封裝。表面貼裝型封裝之一。QFP 或SOP(見QFP 和SOP)的別稱。部分半導體廠家采用此名稱。
7、H-(with heat sink)
H-(with heat sink)表示帶散熱器的標記。例如,HSOP 表示帶散熱器的SOP。
8、MCM(multi-chip module) 多芯片組件
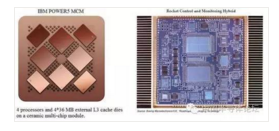
MCM(multi-chip module)
MCM(multi-chip module)是指將多塊半導體裸芯片組裝在一塊布線基板上的一種封裝。根據基板材料可分為MCM-L,MCM-C 和MCM-D 三大類。
MCM-L 是使用通常的玻璃環氧樹脂多層印刷基板的組件。布線密度不怎么高,成本較低。
MCM-C 是用厚膜技術形成多層布線,以陶瓷(氧化鋁或玻璃陶瓷)作為基板的組件,與使用多層陶瓷基板的厚膜混合IC 類似。兩者無明顯差別。布線密度高于MCM-L。
MCM-D 是用薄膜技術形成多層布線,以陶瓷(氧化鋁或氮化鋁)或Si、Al 作為基板的組件。 布線密謀在三種組件中是最高的,但成本也高。
9、P-(plastic)
P-(plastic) 表示塑料封裝的記號。如PDIP 表示塑料DIP。
10、Piggy back
Piggy back是指馱載封裝。指配有插座的陶瓷封裝,形關與DIP、QFP、QFN 相似。在開發帶有微機的設備時用于評價程序確認操作。例如,將EPROM 插入插座進行調試。這種封裝基本上都是定制品,市場上不怎么流通。

以上是關于芯片封裝技術大全(上)的相關內容介紹了,希望能對您有所幫助!
想要了解關于先進封裝清洗的相關內容,請訪問我們的“先進封裝清洗”專題了解相關產品與應用 !
合明科技是一家電子水基清洗劑 環保清洗劑生產廠家,其產品覆蓋助焊劑、PCBA清洗、線路板清洗、電路板清洗、半導體清洗 、芯片清洗、SIP系統級封裝清洗、POP堆疊芯片清洗、倒裝芯片清洗、晶圓級封裝清洗、助焊劑清洗劑等電子加工過程整個領域。





![[x]](/template/default/picture/closeimgfz1.svg)