因為專業
所以領先


在芯片封裝領域,常見的封裝方式有雙列直插式封裝(DIP)、單列直插式封裝(SIP)、方形扁平式封裝(QFP)、四側無引腳扁平封裝(QFN)、插針網格陣列封裝(PGA)、球柵陣列封裝(BGA)、芯片尺寸封裝(CSP)、系統級封裝(SiP)、板上芯片封裝(COB)等 。
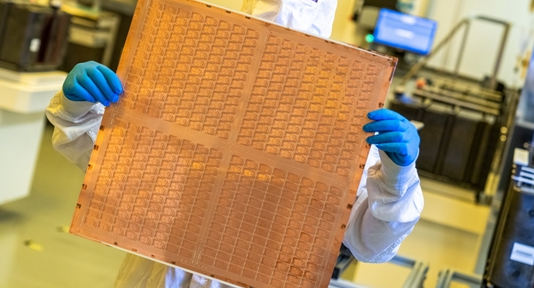
雙列直插式封裝(DIP):這是一種插裝型封裝,引腳從封裝兩側引出。其封裝材料有塑料和陶瓷兩種,是最普及的插裝型封裝。例如,它可應用于標準邏輯IC、存貯器LSI、微機電路等。引腳中心距為2.54mm,引腳數從6到64不等,封裝寬度通常為15.2mm。還有寬度為7.52mm和10.16mm的封裝,分別稱為skinnyDIP和slimDIP,但多數情況下并不特別區分,統一稱為DIP 。
單列直插式封裝(SIP):也是插裝型封裝的一種,引腳從封裝的一側引出。
方形扁平式封裝(QFP):屬于表面貼裝型封裝。其中包括塑料方形扁平式封裝(PQFP)和帶緩沖墊的四側引腳扁平封裝(BQFP)等。例如BQFP封裝在封裝本體的四個角設置突起(緩沖墊),可以防止在運送過程中引腳發生彎曲變形,引腳中心距0.635mm,引腳數從84到196左右 。
四側無引腳扁平封裝(QFN):這種封裝的四周沒有引腳,而是在封裝底部有引腳或焊盤與電路板連接。
插針網格陣列封裝(PGA):例如碰焊PGA封裝(butt joint pin grid array)是表面貼裝型PGA的別稱。在這種封裝方式中,針腳集中在CPU的PCB身上,主板只需要提供插入針腳的插孔即可。并且由于可能需要多次移動,PGA的針腳相對于一些其他封裝方式來說強度會更高,即使出現了彎曲,也能通過相對簡單的方法恢復 。
球柵陣列封裝(BGA):這是一種表面貼裝型封裝,在印刷基板的背面按陣列方式制作出球形凸點用以代替引腳,在印刷基板的正面裝配LSI芯片,然后用模壓樹脂或灌封方法進行密封。其優點是引腳可以超過200,適用于多引腳LSI,例如引腳中心距為1.5mm的360引腳BGA僅為31mm見方;而引腳中心距為0.5mm的304引腳QFP為40mm見方,并且BGA不用擔心QFP那樣的引腳變形問題。該封裝由美國Motorola公司開發,首先在便攜式電話等設備中被采用,目前也有可能在個人計算機中普及 。
芯片尺寸封裝(CSP):這種封裝方式使得芯片尺寸與封裝尺寸非常接近,具有小尺寸、高性能等特點。
系統級封裝(SiP):是將多個不同功能的芯片,如處理器、存儲器、傳感器等集成在一個封裝內,實現系統功能的封裝方式。
板上芯片封裝(COB):是裸芯片貼裝技術之一,半導體芯片直接貼裝在印刷線路板上,芯片與基板的電氣連接用引線縫合方法實現 。
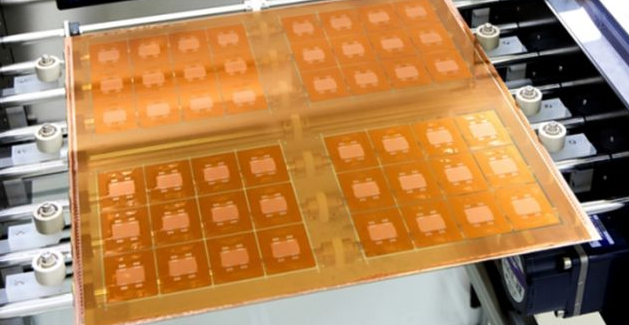
雙列直插式封裝(DIP)中的作用
電氣連接:封裝基板為芯片與外部電路提供電氣連接的通道,通過基板上的線路將芯片的引腳與PCB板上的電路連接起來,使得信號能夠在芯片和外部電路之間傳輸。例如在一些簡單的微機電路中,DIP封裝的芯片通過封裝基板將內部的邏輯信號傳輸到外部的其他電路元件中。
物理保護:保護芯片免受外界物理因素的影響,如灰塵、濕氣等。由于DIP封裝的芯片是插裝在插座或直接焊接在PCB板上的,封裝基板可以作為芯片的外殼,防止芯片受到碰撞、擠壓等物理損害。
尺寸過渡:在一些應用中,芯片的尺寸可能較小,而外部電路的連接點間距較大,封裝基板可以起到尺寸過渡的作用,將芯片的小尺寸引腳布局轉換為適合與PCB板連接的較大間距引腳布局。
方形扁平式封裝(QFP)中的作用
電氣連接與信號傳輸優化:QFP封裝的引腳較多且間距較小,封裝基板需要精確地設計線路布局,以確保各個引腳之間的信號傳輸的準確性和穩定性。例如在計算機的主板電路中,QFP封裝的芯片通過封裝基板實現高速信號的傳輸,如數據信號、時鐘信號等。
應力緩和:由于QFP封裝的引腳較細且長,在受到溫度變化、機械振動等因素影響時,容易產生應力。封裝基板可以通過自身的材料特性和結構設計,緩和這些應力對芯片和引腳的影響,防止引腳斷裂或芯片損壞。
散熱輔助:雖然QFP封裝的散熱能力相對有限,但封裝基板仍然可以在一定程度上幫助芯片散熱。通過選擇具有一定導熱性能的基板材料,將芯片產生的熱量傳導出去,避免芯片過熱。
球柵陣列封裝(BGA)中的作用
高密度電氣連接:BGA封裝通過球形凸點與印刷基板連接,這種方式可以實現更高密度的電氣連接。封裝基板在其中起到了關鍵的承載和連接作用,精確地布局線路以匹配BGA芯片的眾多引腳(凸點),確保信號的高效傳輸。例如在現代高性能的計算機處理器中,BGA封裝的芯片利用封裝基板實現大量數據和控制信號的快速交換。
散熱管理:BGA封裝的芯片通常功率較大,產生的熱量較多。封裝基板的材料和結構設計對散熱有著重要影響。一些高性能的BGA封裝基板采用具有高導熱性的材料,如陶瓷或特殊的復合材料,能夠有效地將芯片產生的熱量傳導出去,防止芯片因過熱而性能下降或損壞。
機械支撐與保護:為BGA芯片提供機械支撐,確保芯片在安裝和使用過程中的穩定性。同時,封裝基板也保護芯片免受外界環境的影響,如防止濕氣、化學物質等對芯片的侵蝕。
系統級封裝(SiP)中的作用
多功能集成連接:在SiP封裝中,多個不同功能的芯片集成在一起。封裝基板要實現這些不同芯片之間的電氣連接,就像一個小型的電路板一樣,將處理器、存儲器、傳感器等芯片按照設計要求進行連接,使它們能夠協同工作。例如在智能手機的SiP封裝中,封裝基板將應用處理器、基帶芯片、射頻芯片等連接起來,實現手機的通信、計算等多種功能。
信號完整性保障:由于SiP封裝內集成了多種功能的芯片,信號傳輸的復雜性增加。封裝基板需要通過合理的布線、電磁屏蔽等措施來保障信號的完整性,防止信號干擾和衰減。例如在一些高速數據傳輸的SiP封裝中,采用特殊的線路布局和屏蔽層設計來確保數據信號的準確傳輸。
整體物理保護與小型化:為集成在其中的多個芯片提供整體的物理保護,同時有助于實現整個封裝的小型化。通過將多個芯片封裝在一起,可以減少整個系統的體積,而封裝基板的設計和制造要滿足這種小型化的要求,同時保證芯片在封裝內的安全性。
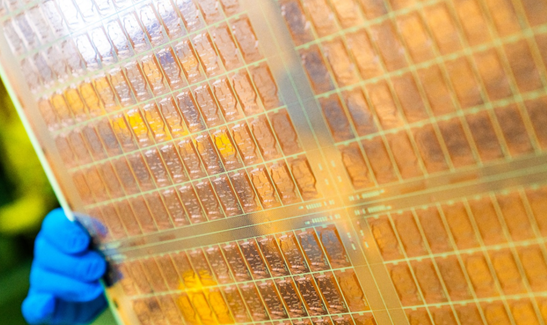
雙列直插式封裝(DIP)應用案例
早期計算機電路:在早期的計算機主板設計中,許多標準邏輯IC和微機電路采用DIP封裝。例如,Intel的早期微處理器芯片就有DIP封裝的形式。這些芯片通過DIP封裝方便地插裝在主板的插座上,通過封裝基板與主板上的其他電路元件如電阻、電容等進行電氣連接。由于當時的生產工藝和電路設計水平,DIP封裝的較大尺寸和相對簡單的結構能夠滿足計算機電路的需求。
工業控制設備:在一些工業控制領域,如自動化生產線的控制器、電機驅動器等設備中,DIP封裝的芯片仍然被廣泛使用。因為這些設備對可靠性要求較高,DIP封裝的芯片在惡劣的工業環境下,其封裝基板能夠較好地保護芯片免受灰塵、濕氣和電磁干擾等影響。同時,DIP封裝的芯片便于在設備維護和升級時進行更換,只要將芯片從插座上拔出,插入新的芯片即可。
方形扁平式封裝(QFP)應用案例
消費電子產品中的芯片:在現代消費電子產品,如智能手機、平板電腦等設備中,大量的芯片采用QFP封裝。例如,一些音頻處理芯片、電源管理芯片等可能采用QFP封裝。這些芯片通過封裝基板與設備主板上的其他電路組件進行連接,實現音頻信號處理、電源分配等功能。由于QFP封裝的小尺寸和相對較多的引腳數,能夠滿足消費電子產品對芯片功能集成度和小型化的要求。
通信設備中的信號處理芯片:在通信基站、路由器等通信設備中,許多信號處理芯片采用QFP封裝。例如,在數字信號處理(DSP)芯片中,QFP封裝可以提供足夠的引腳用于輸入輸出信號的連接,同時封裝基板能夠保證信號在芯片內部和外部之間的高速穩定傳輸。在通信設備的高頻信號處理中,QFP封裝的芯片通過封裝基板實現對微弱信號的精確處理和傳輸,滿足通信系統對信號質量的嚴格要求。
球柵陣列封裝(BGA)應用案例
計算機處理器和圖形處理器(GPU):現代計算機的中央處理器(CPU)和圖形處理器(GPU)大多采用BGA封裝。例如,Intel和AMD的CPU以及NVIDIA和AMD的GPU都廣泛使用BGA封裝。這些高性能的芯片通過BGA封裝的球形凸點與封裝基板連接,封裝基板采用多層結構,內部包含復雜的線路布局,以滿足芯片與外部設備(如內存、主板芯片組等)之間大量數據的高速傳輸需求。同時,由于CPU和GPU的功耗較高,BGA封裝的封裝基板需要具備良好的散熱性能,采用銅、鋁等散熱材料或特殊的散熱結構,如散熱孔、散熱層等,來確保芯片在高負載運行時的穩定性。
智能手機中的應用處理器(AP):在智能手機中,應用處理器(AP)是核心芯片之一,也常采用BGA封裝。例如,高通驍龍系列和蘋果A系列芯片在智能手機中的應用。這些芯片通過BGA封裝與手機主板連接,封裝基板在其中起到了連接芯片與主板上其他組件(如內存、射頻芯片等)的作用,同時要滿足手機對輕薄化、高性能和低功耗的要求。由于手機內部空間有限,BGA封裝的小尺寸和高集成度特點能夠有效節省空間,而封裝基板的設計要在保證電氣性能的前提下盡可能地減小厚度和體積。
系統級封裝(SiP)應用案例
智能手機:如前所述,智能手機是SiP封裝的典型應用領域。以蘋果iPhone為例,其內部的系統級封裝集成了多個芯片,包括應用處理器、基帶芯片、電源管理芯片、射頻芯片等。封裝基板將這些不同功能的芯片連接在一起,實現了手機的各種功能,如通信、計算、拍照、音頻處理等。通過SiP封裝,可以減小手機內部的空間占用,提高信號傳輸速度,并且增強了手機的整體性能和可靠性。
可穿戴設備:在智能手表、智能手環等可穿戴設備中,SiP封裝也得到了廣泛應用。由于可穿戴設備對體積和功耗的要求更為嚴格,SiP封裝能夠將多個必要的芯片集成在一起,如傳感器芯片(加速度計、心率傳感器等)、微控制器芯片、藍牙芯片等。封裝基板在其中起到了整合這些芯片功能的作用,使得可穿戴設備能夠在極小的空間內實現多種功能,并且能夠有效地降低功耗,延長電池續航時間。
雙列直插式封裝(DIP)對封裝基板的性能要求
機械強度:DIP封裝的芯片需要插入插座或焊接在PCB板上,在這個過程中,封裝基板需要具備一定的機械強度,以防止在插拔或焊接過程中基板破裂或變形。例如,當芯片插入插座時,如果基板的機械強度不足,可能會導致引腳與插座之間的連接不良。
電氣絕緣性:由于芯片的引腳通過封裝基板與外部電路連接,基板需要具備良好的電氣絕緣性,防止引腳之間發生短路。在一些高壓電路應用中,如電力電子設備中的DIP封裝芯片,對封裝基板的電氣絕緣性要求更高。
尺寸精度:雖然DIP封裝相對尺寸較大,但仍然需要一定的尺寸精度,以確保芯片能夠準確地插入插座或與PCB板上的焊接點匹配。如果封裝基板的尺寸精度不夠,可能會導致芯片安裝困難或者電氣連接不良。
方形扁平式封裝(QFP)對封裝基板的性能要求
高精度布線:QFP封裝的引腳間距較小,通常在0.635mm左右,這就要求封裝基板具有高精度的布線能力。基板上的線路需要精確地與引腳連接,并且線路之間的間距要符合電氣安全標準,防止信號串擾。例如在一些高速信號傳輸的QFP封裝芯片中,線路的寬度和間距可能需要精確到幾十微米。
良好的熱性能:由于QFP封裝的散熱能力相對有限,封裝基板需要具備一定的熱傳導性能,以便將芯片產生的熱量傳導出去。特別是在一些功率較大的QFP封裝芯片應用中,如功率放大器芯片,對封裝基板的熱導率要求較高。
低應力特性:QFP封裝的引腳較細且長,容易受到應力的影響。封裝基板需要具有低應力特性,能夠在溫度變化、機械振動等情況下,減少對引腳的應力作用,防止引腳斷裂。這就要求基板的材料選擇和結構設計要考慮到應力的因素,例如采用熱膨脹系數與芯片和外部電路相匹配的材料。
球柵陣列封裝(BGA)對封裝基板的性能要求
高密度布線與微孔技術:BGA封裝的引腳(凸點)數量眾多且間距小,這就要求封裝基板能夠實現高密度布線。為了滿足這一要求,基板需要采用微孔技術,即在基板內部制作微小的導通孔,以實現多層線路之間的連接。例如在一些高端的BGA封裝芯片中,微孔的直徑可能只有幾十微米。
高導熱性:BGA封裝的芯片功率較大,產生的熱量較多,因此封裝基板需要具備高導熱性。可以采用高導熱系數的材料,如陶瓷、金屬基復合材料等作為基板材料,或者在基板內部設計散熱通道,如散熱孔、散熱層等,以提高散熱效率。
良好的平面度:BGA封裝是通過球形凸點與基板連接的,要求基板表面具有良好的平面度。如果基板表面不平整,可能會導致球形凸點與基板之間的接觸不良,影響電氣連接和散熱性能。
系統級封裝(SiP)對封裝基板的性能要求
多功能集成能力:SiP封裝集成了多個不同功能的芯片,這就要求封裝基板具有多功能集成的能力。基板需要在有限的空間內實現不同芯片之間的電氣連接、信號傳輸、電源分配等功能,并且要滿足不同芯片對電氣性能的要求。例如,在集成處理器和存儲器的SiP封裝中,封裝基板需要同時滿足處理器的高速數據傳輸需求和存儲器的穩定供電需求。
信號完整性保障:由于SiP封裝內信號傳輸的復雜性,封裝基板需要具備保障信號完整性的能力。這包括采用低介電常數的材料、合理的布線布局、電磁屏蔽等措施。例如在一些高速數字信號傳輸的SiP封裝中,采用特殊的信號屏蔽層來防止外部電磁干擾對內部信號的影響。
小型化與輕薄化:為了滿足可穿戴設備、智能手機等對小型化和輕薄化的要求,SiP封裝的封裝基板需要具備小型化和輕薄化的性能。這就要求在基板的材料選擇、結構設計和制造工藝上進行優化,在保證功能的前提下,盡可能減小基板的厚度和面積。
電氣性能方面
連接密度:BGA封裝方式下,封裝基板的電氣連接密度最高,因為其采用球形凸點陣列,可以在較小的面積上實現大量引腳的連接。例如在計算機處理器的BGA封裝中,數百個引腳可以緊密排列。相比之下,DIP封裝的連接密度最低,其引腳從兩側引出,引腳數量相對有限,且間距較大。QFP封裝的連接密度介于兩者之間,雖然引腳較多,但由于是扁平式封裝,引腳間距的進一步縮小存在一定限制。SiP封裝則更注重多個芯片之間的集成連接,其內部的連接密度根據不同芯片的組合和功能需求而有所不同,但總體上能夠在較小的封裝體積內實現復雜的電氣連接。
信號傳輸速度:在高速信號傳輸方面,BGA和QFP封裝如果采用合適的封裝基板和設計,都能夠實現較高的信號傳輸速度。例如在通信設備中的高速信號處理芯片,QFP封裝通過精確的封裝基板布線和信號完整性設計,可以滿足高速數據的傳輸需求。然而,BGA封裝由于其球形凸點連接的低電感特性,在一些高頻應用中可能具有更好的信號傳輸性能。SiP封裝由于集成了多個芯片,信號傳輸的路徑更為復雜,需要在封裝基板上采取更多的信號完整性保障措施,如采用低介電常數的材料、優化布線等,以確保信號在不同芯片之間的高速穩定傳輸。DIP封裝由于其較大的引腳間距和相對簡單的結構





![[x]](/template/default/picture/closeimgfz1.svg)